


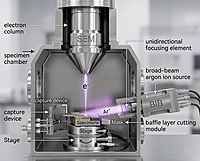


ABSEM200 Argon Ion Beam Field Emission Scanning Electron Microscope
The ABSEM200 represents a significant advancement in sample preparation and analysis, combining a broad-beam argon ion source with a field emission scanning electron microscope (FE-SEM) in a single, integrated platform. By enabling in-situ ion beam polishing directly within the SEM chamber, the system eliminates the need for sample transfer, reducing contamination risk and significantly improving workflow efficiency.
Designed for high-performance materials characterisation, the ABSEM200 utilises broad ion beam (BIB) technology to process large, millimetre-scale samples with ease, expanding the scope of applications beyond traditional preparation methods. Its grazing-angle ion beam approach minimises surface damage, preserving the true microstructure and integrity of sensitive samples.
A precision nanometre-scale layer removal module allows for controlled cross-sectioning and serial sectioning, while an integrated debris trapping system ensures stable operation and prevents contamination during processing.
The ABSEM200 is particularly well suited to complex, heterogeneous, or environmentally sensitive materials, delivering high-resolution imaging alongside controlled, artefact-minimised sample preparation. It provides a powerful, streamlined solution for laboratories seeking efficient, high-quality microstructural analysis.



